Modes électriques avancés pour AFM

Uniquement disponible
avec le Nano-Observer AFM
1. HD-KFM : High Definition Kelvin Force Microscopy
2. ResiScope II :Courant/ Resistance sur 10 décades
3. Soft ResiScope : ResiScope sur échantillons délicats
5. sMIM : Cartographie permittivité et conductivité au nm
Très haute sensibilité
Résolution spatiale supérieure
La microscopie à force Kelvin (KFM) permet de mesurer le potentiel de surface entre une pointe conductrice oscillante et la surface. La mesure du potentiel de surface peut être utilisée pour déterminer des propriétés intrinsèques telles que la fonction de travail ou la bande interdite. CSInstruments a développé une implémentation ultra-sensible de KFM, appelée High Definition-KFM (HD-KFM), qui utilise 2 mémorisations adaptées aux deux premières fréquences en mode propre du cantilever pour acquérir à la fois la topographie et le potentiel de surface. Cette configuration combine les avantages de l’approche en un seul passage avec l’amélioration du signal électrique grâce à l’adaptation de résonance mécanique.
- La science des matériaux
- Semi-conducteur
- Polymère
- Sciences de la vie
Mesure réalisée avec un scanner de 100µm et un z de 12µm
HD-KFM, Graphène, 8µm
HD-KFM Le mode KFM à passe unique le plus avancé
Le HD-KFM développé par CSI pour le Nano-Observer AFM présente l’avantage d’amplifier le signal de retour via le deuxième mode propre du cantilever. Cela permet également de sonder de plus près le champ électrique créé par le potentiel de surface par rapport aux autres approches. Ceci est d'une importance extrême pour l'imagerie de petites molécules ou de matériaux bidimensionnels.
- Cartographie du potentiel de surface
- 2ème amplificateur de verrouillage
- NO LIFT: très haute sensibilité et résolution spatiale supérieure
Sensibilité et résolution beaucoup plus élevées
L’un des avantages évidents de l’approche en une passe par rapport à la mise en œuvre en double passe est l’amélioration de la résolution et de la sensibilité car la pointe reste dans le régime sans contact, mais également beaucoup plus proche de la surface, comme illustré dans la figure ci-dessous. Une comparaison directe entre les deux techniques est effectuée sur un échantillon de graphène sur un substrat de SiC. L'image de potentiel de contact obtenue en configuration en une seule passe permet d'obtenir un meilleur contraste et une meilleure résolution latérale des domaines du graphène. Ceci est dû au fait que dans une approche en une seule passe, la pointe oscille plus près de la surface (typiquement 0,1 nm à 0,3 nm ou touche la surface de façon intermittente) par rapport au mode double passage ou au mode levage (typiquement 10 nm à 20 nm). ). Lorsque le champ électrique décroît avec la distance de séparation, le double passage standard présente une perte intrinsèque de sensibilité et de résolution latérale.
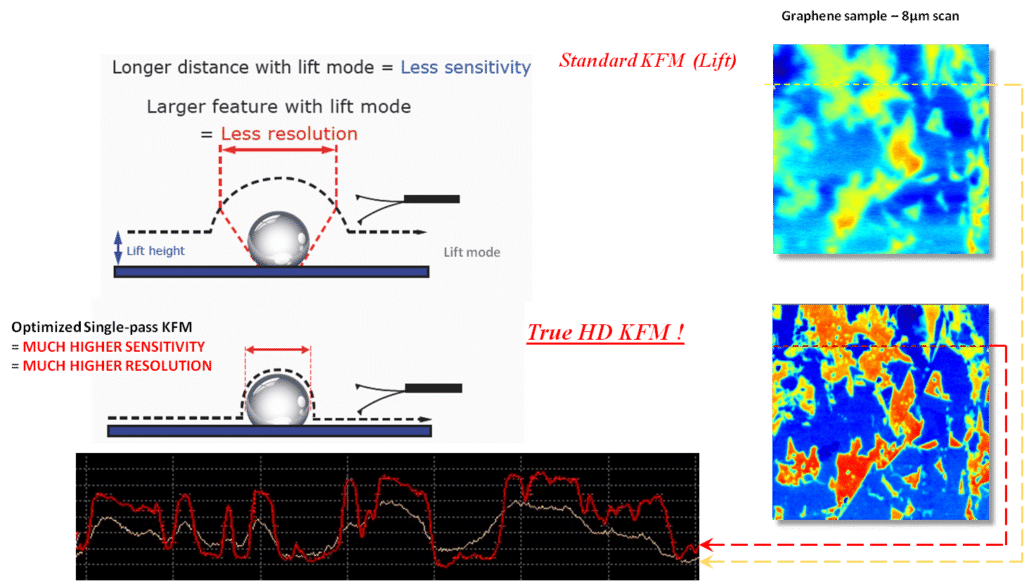
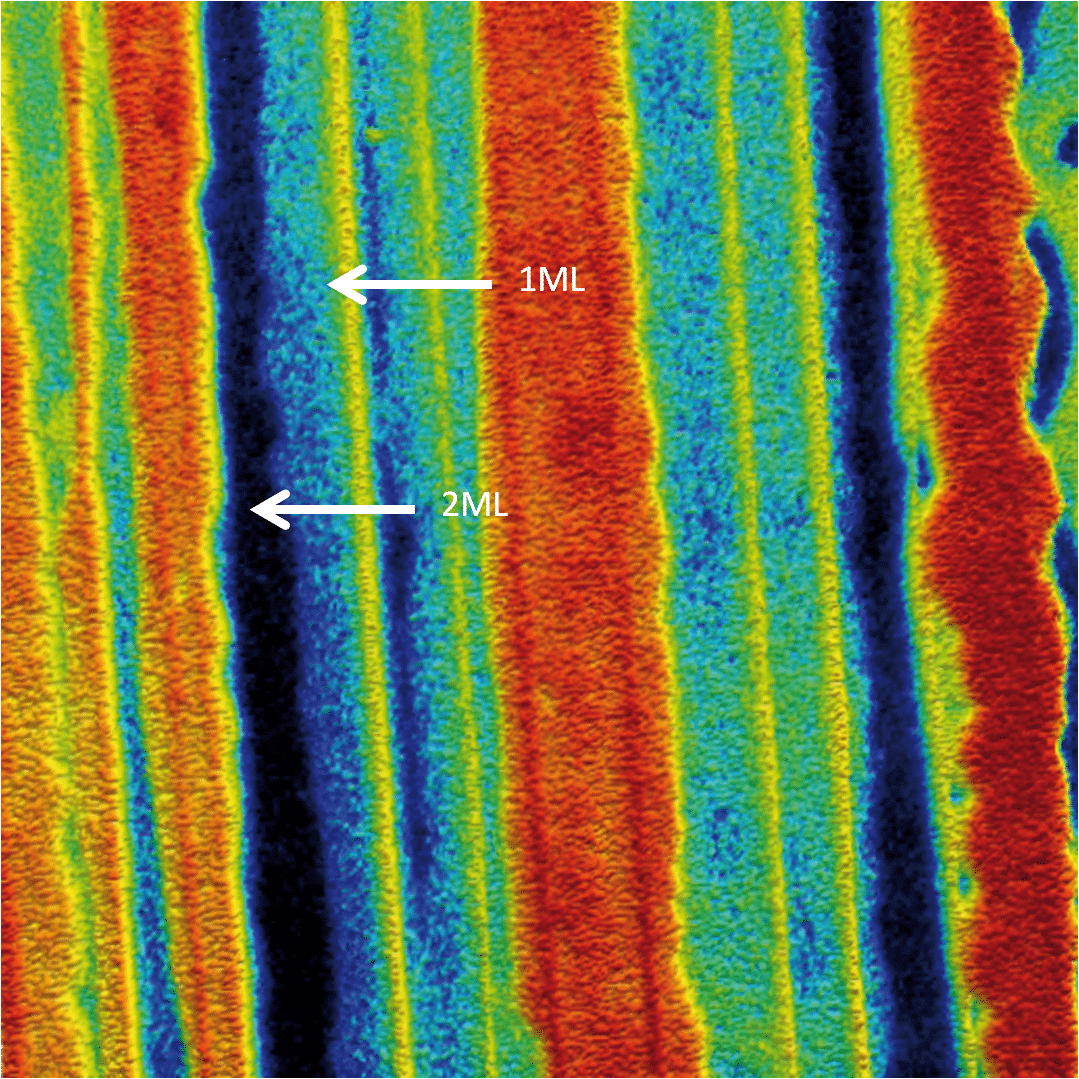
Surface potential, Graphene, 8μm

Biomolecules, HD-KFM mode, 1µm

Stainless steel, HD-KFM mode, 20µm

Fluoroalcane, HD-KFM mode, 0.7µm
ResiScope
Courant et Résistance sur 10 décades
Le ResiScope II est un système unique capable de mesurer la résistance en AFM sur 10 décades avec une sensibilité et une résolution élevées. Il peut être associé à plusieurs modes dynamiques, tels que MFM / EFM (mode AC / MAC) ou KFM à passe unique (AC / MAC III), permettant ainsi de caractériser plusieurs échantillons sur la même zone de numérisation.
La mesure est effectuée en appliquant une polarisation CC entre l'échantillon et une sonde AFM conductrice (pointe à la terre virtuelle). L'embout numérise en mode contact en utilisant la déviation laser pour le retour AFM. En tant que mesure indépendante, le ResiScope II mesure la résistance de l'échantillon via l'amplificateur haute performance (HPA).
- Cartographie de résistance et de courant
- Dynamique de 10 décades : résistance de 102 ohms à 1012 ohms
- Haute sensibilité sur toute la gamme
- Informations de sortie :
spectroscopie R, log R, courant et I / V - Compatible avec les modes oscillant, EFM / MFM ou KFM...
Qu'est ce que le ResiScope ?
"La plus grande performance au monde pour la caractérisation électrique AFM."
Principe
Lors de la mesure, le DSP choisit en temps réel le meilleur gain pour optimiser la mesure effectuée par le module amplificateur (HPA). Cette condition de fonctionnement permet une très grande sensibilité sur toute la plage de résistivité à une vitesse de balayage régulière (AFM). Contrairement à d'autres techniques, le courant entre la sonde et l'échantillon est fortement réduit. Ceci a pour résultat de limiter l'effet local de l'oxydation ou de l'électrochimie et de protéger la sonde conductrice des dommages causés par un courant élevé.
Logiciel intuitif
- Facile à utiliser
- Sélection automatique du mode
- Sorties configurables
- Échelle de sortie sélectionnable: R | Log R | Courant
Awards
- 2014 : « Yves Rocard 2014 » Prize (Société Française de physique)
-
FIEEC Prize for Applied Research at « Rendez-Vous Carnot 2013 »

Carbon black stripe , ResiScope mode, 60µm

Organic Solar Cell layer, ResiScope mode, 5µm

Aliage, ResiScope mode, 50µm

Stainless steel, resiscope mode, 1µm

SBS, ResiScope mode, 3µm

Nanotube on ITO, Soft ResiScope mode, 6µm


Soft ResiScope
Véritables mesures quantitatives de résistance / courant avec contact intermittent pour les matériaux tendres
Caractérisation électrique AFM sur un échantillon souple
Ce mode AFM unique et innovant est en mesure d’étendre les domaines d’application du «ResiScope II» aux échantillons souples tels que les cellules solaires organiques, les polymères conducteurs ou d’autres échantillons biologiques, tout en conservant son large domaine de mesure (10 décennies). Le principe Soft ResiScope est basé sur le contact intermittent.
- Technologie unique
- PAS DE FRICTION
- Force constante = Mesures électriques quantitatives
- Les polymères
- Matières organiques
- Cellules solaires
- Échantillon biologique
Performance et échantillon préservés
Principe
Le principe Soft ResiScope est basé sur le contact intermittent. La sonde AFM ne reste en contact avec l'échantillon que pendant un court laps de temps avec un contrôle de force constant qui permet au ResiScope II de mesurer la résistance et le courant dans les meilleures conditions pour les mesures quantitatives. Ensuite, la pointe est rétractée et passe à l'étape suivante.
Mode Soft ResiScope VS Modes oscillant / contact
Cette nouvelle méthode non destructive «soft ResiScope» a été comparée au mode oscillant conventionnel sur des échantillons fragiles (mélange de polymères). Les résultats étaient totalement équivalents. Cette figure montre les premières lignes du balayage mesuré en mode oscillant et l’autre partie en mesurant en mode Soft ResiScope. On peut également remarquer la surface endommagée par le scan précédent effectué en mode contact (carré bleu), la surface était rayée par la pointe.
Mesures quantitatives
Modes Soft ResiScope VS standard
L'image suivante illustre les mesures quantitatives avec Soft ResiScope. La comparaison a été faite entre les mesures ResiScope en mode de contact et le mode Soft ResiScope sur un échantillon électrique standard tel que SRAM. Le résultat ne montre aucune différence entre le mode de contact et le mode Soft ResiScope sur la topographie et les signaux de résistance. De plus, la section montre des résultats identiques entre les modes Standard ResiScope et Soft ResiScope.

P3HT, Soft ResiScope mode, 5µm

AU, Soft ResiScope mode, 5µm

Nano-tube, Soft ResiScope mode, 5µm
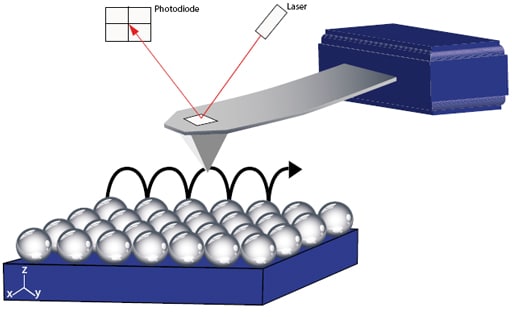


Ligne rouge: Soft ResiScope , mode intermittent
Ligne bleue: ResiScope standard, mode contact
sMIM
Scanning Microwave Impedance Microscopy (sMIM)
Ce nouveau mode AFM, développé par PrimeNano, mesure les propriétés électriques des matériaux à des échelles de longueurs allant de 10 nanomètres à microns. Les modules sMIM produisent des images de haute qualité de propriétés électriques locales avec une résolution supérieure à 50 nm. Notre approche technique consiste à utiliser les réflexions hyperfréquences à partir d’une région à l’échelle nm de l’échantillon directement sous la sonde SMIM.
- Sensibilité aux métaux, aux semi-conducteurs et aux isolants, y compris les diélectriques
- Conductivité de mesure directe σ & ε permittivité à l'échelle nanométrique
- Relation linéaire avec les propriétés électriques
- Cartographie quantitative de la concentration en dopage
- Spectres C-V à l'échelle nanométrique
- Capacité de détection sous la surface
Conductivité, permittivité et concentration en n-dopage
Principe
- ScanWave ™ envoie des micro-ondes à la pointe de la sonde via un chemin entièrement blindé.
- Les micro-ondes créent une onde électromagnétique en champ proche à l'extrémité de la sonde qui interagit avec la surface et le sous-sol de l'échantillon.
- Une fois que le champ proche a interagi avec l'échantillon, une partie de la puissance hyperfréquence est réfléchie par le même chemin blindé vers l'électronique ScanWave ™ pour le filtrage, la démodulation et le traitement.
- Lorsque la sonde se déplace dans l'échantillon, l'amplitude et la phase des micro-ondes réfléchies varient en raison des variations des propriétés électriques locales sous la pointe de la sonde.
- Le logiciel ScanWave ™ étalonne le signal réfléchi à partir de l'interface sonde-échantillon pour créer une image capacitive et une image résistive qui sont affichées par l'AFM simultanément avec l'image ou les images topographiques.
Pointes sMIM
Les pointes SMIM sont des dispositifs MEMS fabriqués par lots (systèmes micro-électriques électriques) avec une ligne de transmission blindée à l'avant et à l'arrière et au centre. Le blindage de la sonde réduit le couplage parasite de l'environnement et du porte-à-faux. Le rayon de la sonde est nominalement 50 nm pour optimiser l’intensité du signal et la résolution latérale. L’interface échantillon de la sonde utilise une résistance et un condensateur en parallèle. Ce «condensateur à fuite» présente un décalage d'impédance avec l'électronique du système de 50 ohms, créant une réflexion.
Lorsque la pointes sMIM est déplacée sur la surface de l’échantillon, l’impédance de ce condensateur qui fuit est modifiée et les modifications résultantes des parties réelle et imaginaire de l’onde réfléchie sont émises sous forme de deux signaux provenant de l’électronique ScanWave. Ces signaux sont numérisés par l’AFM pour produire les images sMIM-C et sMIM-R synchronisées avec les images topographiques.

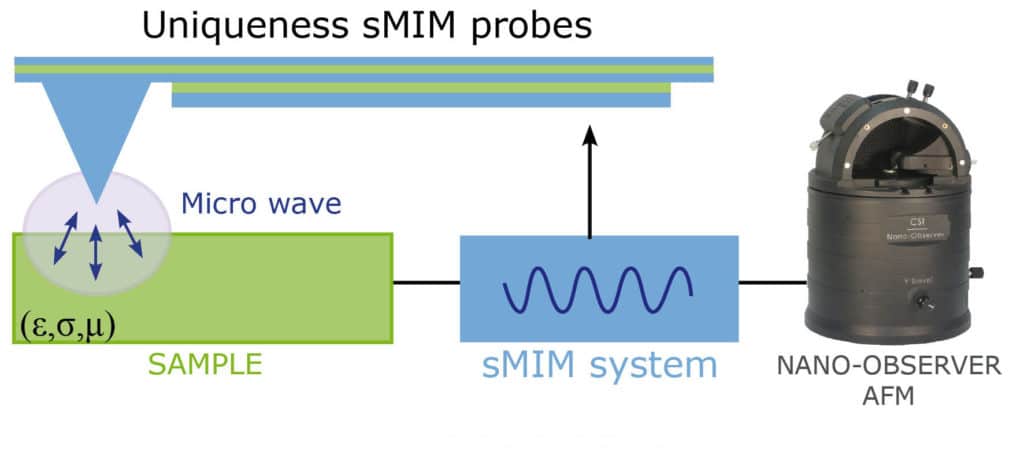
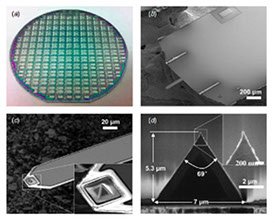
Accessoires
Contactez-nous pour plus d'informations sur ce produit
Vous souhaitez un devis ?
Des informations complémentaires ?
Nous vous répondrons dans un délai de 24h






